Facility Name
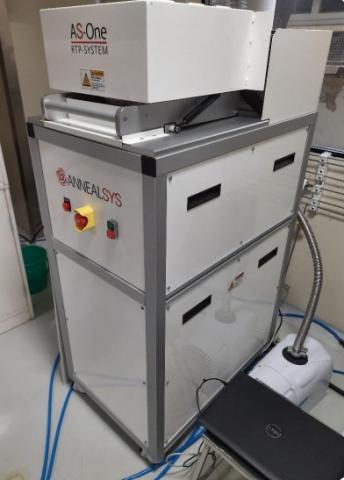
External users: registration to be carried out only through I-STEM portal
Additional information about sample and analysis details should be filled in the pdf form provided in the I-STEM portal under “DOWNLOAD CSRF”
Internal users (IITB): registration to be carried out only through DRONA portal
Additional information about sample and analysis details should be filled in the pdf form provided here.
.
Category
- Fabrication and Processing » Nanofabrication
- Fabrication and Processing » Nanofabrication
Booking Details
Facility Management Team and Location
Facility Features, Working Principle and Specifications
Facility Description
The rapid thermal processor has the capability to run the following processes (a) Rapid thermal annealing of compound semiconductors (b) Rapid Thermal Oxidation (RTO) (c) Rapid Thermal Nitridation (RTN)
Temperature range: RT to 900°C
Max Ramp Rate 150°C/s (for Si) 40°C/s (for Susceptor)
Max. Safe Ramp Rate (for Si processing) - 100°C/s
Max. Safe Ramp Rate (for III-V processing using Graphite Susceptor) - 25°C/s
Vacuum range: Atmosphere approx to 1 mBar
NA
Sample Preparation, User Instructions and Precautionary Measures
NA
NA
Charges for Analytical Services in Different Categories
All charges are in INR / hour
| IITB Students TA | IITB students | IITB Monash students | External Academia | National Labs | SINE Start up | Research Park Startup | Research Park Industry | Industry |
| 2500 | 2500 |
Applications
RTA (Rapid Thermal Annealing RTO (Rapid Thermal Oxidation) Diffusion
Compound semiconductor annealing Nitridation, Silicidation Crystallization and Densification
Sample Details
NA
Si
Ar, N2, O2
2 inch Si
NA
Na and K not allowed, metals not allowed
NA
