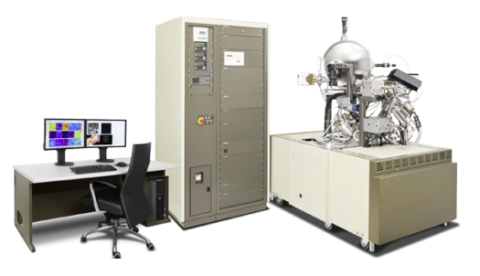
External users: registration to be carried out only through I-STEM portal
Additional information about sample and analysis details should be filled in the pdf form provided in the I-STEM portal under “DOWNLOAD CSRF”
Internal users (IITB): registration to be carried out only through DRONA portal
Additional information about sample and analysis details should be filled in the pdf form provided here.
.
Category
- Spectroscopy and Spectrometry » Mass Spectrometry
Booking Details
Analyzer Specification
Primary: Ion Ga+
Energy: 30keV
Current: 5.8nA
Area: 50X50um2
Cycle Time: 1 Frame (i.e 13.11sec =1 Frame)
Modes of Operation: Positive and Negative
Sputter: Primary Ion Cs(Sputter Ion Gun) Oxygen &Argon (Gas gun)
Energy: 3keV 3keV
Current: 620.00nA 780.00nA
Area: 650x650um2 450x450um2
SpIDD: we can calculate as per requirement
Charge Compensation
with Ion Neutralizer (<10eV) flood of Ar+ E Gun (<10eV) pulsed focused electron beam
Other capabilities and features
3 D mapping capability
Stylus Profilometer (accessory)
Facility Management Team and Location
Facility Features, Working Principle and Specifications
Capabilities:
Mass spectrum study for elemental and organic composition
Elemental and organic species mapping
Dopant and impurity depth profiling
Elemental 3D reconstruction for profile study
Composition and impurity measurements of thin films (metals, dielectrics, SiGe)
High-precision matching of process tools such as ion implanters
WorkingPrinciple: Time-of-Flight Secondary Ion Mass Spectrometry (TOF-SIMS) is a technique in which an ion beam (primary ion) is irradiated on a solid sample and mass separation of the ions emitted from the surface (secondary ions) is performed using the difference in time-of-flight (time-of-flight is proportional to the square root of the weight).
TOF-SIMS can obtain information regarding elements or molecular species within 1 nm of the sample surface at a very high detection sensitivity.
Sample Preparation, User Instructions and Precautionary Measures
ToF SIMS Charges includes GST:
| Tof-SIMS Analysis Per sample/Per session | Industry | University | National Lab/R&D's |
| 9440/- | 1770/- | 4248/- |
Charges for Analytical Services in Different Categories
Applications
Nanodevices
Polymer blends
Pharmaceuticals
Thin films/surface coatings
corrosion
Catalysis
Geologic materials
Glass Industries
